1.管壳馈通组件采用采用HTCC高温陶瓷设计结构,有效增加馈通引线密集度与气密可靠性,满足封装模块小型化需求;
2.散热区域一般采用钨铜、钼铜材料,热导率至高可达到260W/m·K;
3.表面镀层可根据客户需求,满足金丝键合、搪锡、金锡钎焊要求;
4.陶瓷珠也可替代玻璃绝缘子,增强其强度,提高可靠性。

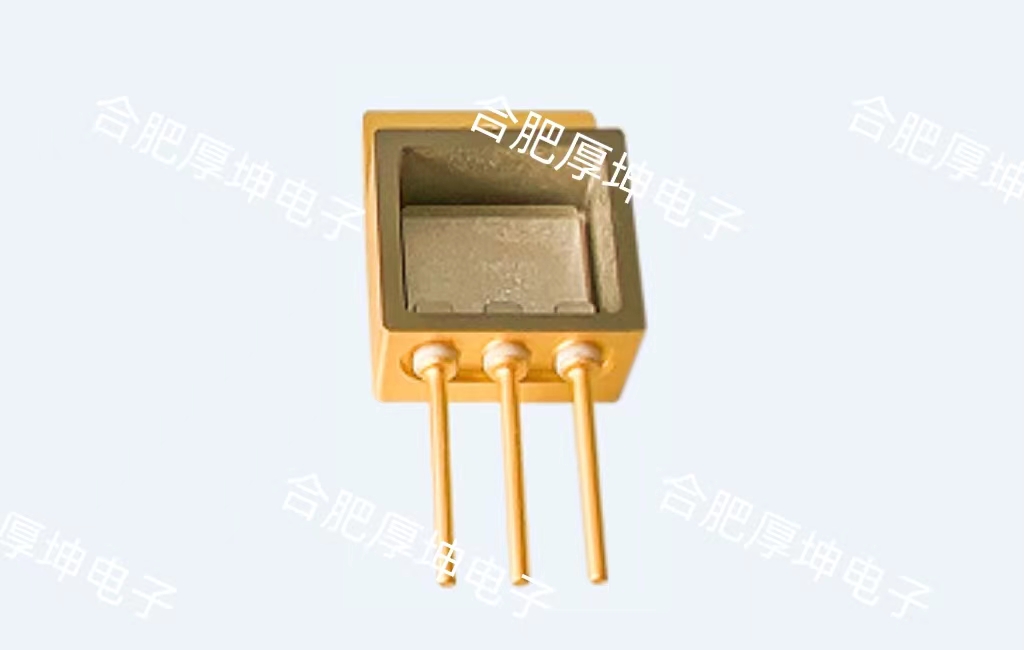

▪ 常用材质:可伐(4J29)、氧化铝陶瓷、优质碳素钢(10#)、铝合金等
▪ 表面处理:电镀镍、金、局部镀金
▪ 封盖方式:可满足平行缝焊>▪ 防盐雾等级:24H/48H
▪ 绝缘电阻:
≥1X109Ω(500V DC )▪ 气密性:
1X10-3Pa·cm3/s(He)
▪ 通讯、工业激光器
▪ 消费电子
▪ 汽车电子等领域